先进光刻技术的发展历程与最新进展 李艳丽
投影光刻物镜像质补偿策略与补偿技术研究_赵磊
高数值孔径投影光刻物镜的光学设计_徐明飞
链接:https://pan.baidu.com/s/1jf2Q-QzNUDXr5Lrd6TJlrA?pwd=x0wt
提取码:x0wt
–来自百度网盘超级会员V6的分享
总结


均匀性/线宽均匀性。;DP(Dipole)为偶极照明。;Etch shrink 为刻蚀缩小线宽(缩孔)。

193 nm干式光刻
林本坚在IBM的时候研究的工件台和镜头相对位移的系统,将k1减小到0.75。再使用双重曝光可以减小一半,也就是0.375。ASML的曝光能量分布测绘功能以及镜头NA提升(结合李艳丽文章推测,这一步是因镜头结构进步NA从0.75提升到0.85,即1.13倍),从90nm推进到65nm,这一步对应的比例式1.38,曝光分布测绘带来的工艺因子提升所占比例为1.38/1.13=1.22,那么k1可以从0.375减小到0.307。从65 nm到45 nm引入浸没式光刻,这一步NA减小1.44倍,完全是水浸的功劳,工艺因子k1这里还是0.307。从45 nm到28 nm,结合林本坚的演讲,有一个镜头结构的优化(使得NA从1.2到了1.35),还厚刻蚀shrink缩孔,可使k1继续减小至0.28。从28nm到更小,靠的是FINFET,还有偏振成像的引入(45nm->28nm),使用SMO配合双层抗反射层(28nm->16/14nm)、SALELE,Self-aligned litho-etch-litho-etch (14nm->7nm),Cut Metal等。

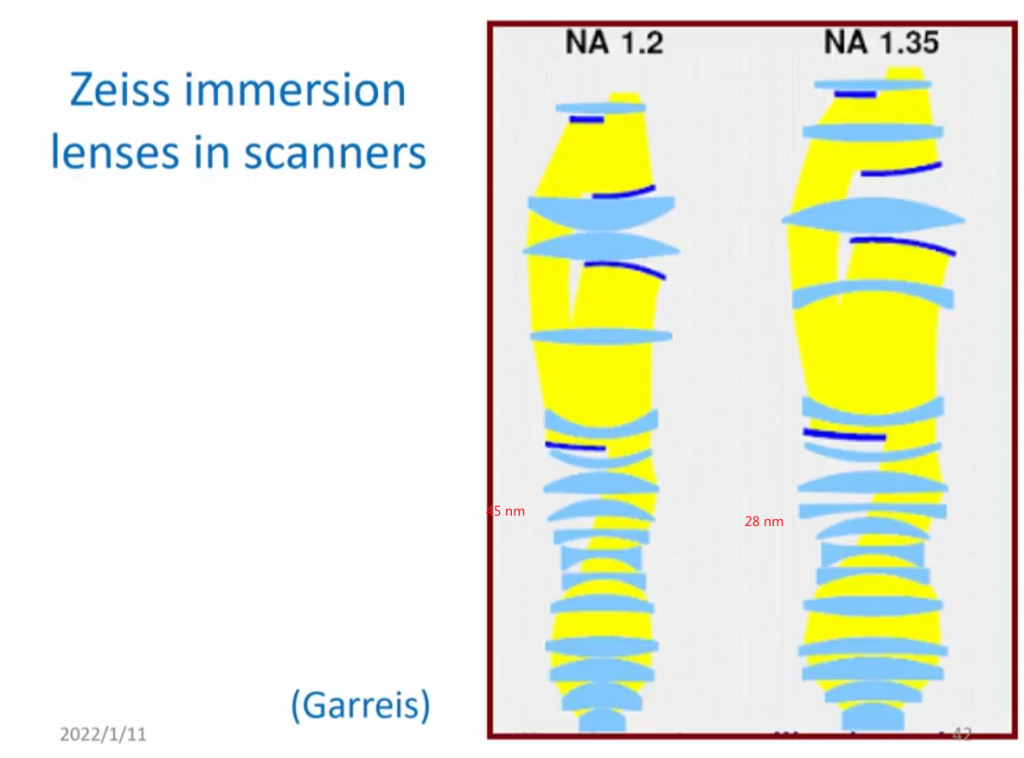
13.5nm EUV
根据《 投影光刻物镜像质补偿策略与补偿技术研究_赵磊 》,2019年长光所应该在研究NA0.75的物镜。
