在侧墙形成后,需要进行的就是源/漏注入工艺。先要进行的是n+源/漏注入,光刻出n型晶体管区域后,进行中等剂量的注入,其深度大于LDD的结深,且二氧化硅构成的侧墙阻止了砷杂质进入狭窄的沟道区。接下来进行P+源/漏注入,在光刻出了要进行注入的P型晶体管区域后,同样进行中等剂量注入,形成的结深比LDD形成的结深略大,侧墙起了同样的阻挡作用。注入后的硅片在快速退火装置中退火,在高温状态下,对于阻止结构的扩展以及控制源/漏区杂质的扩散都非常重要。源/漏注入工艺 的基本过程如下图所示:
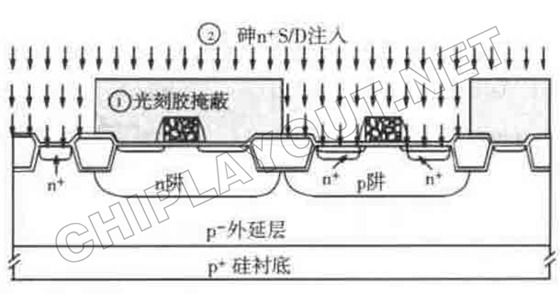
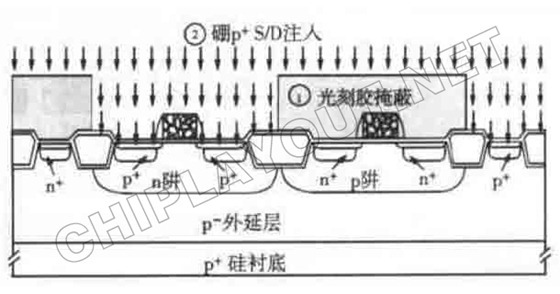
- CMOS制作基本步骤的相关文章
- CMOS制作步骤(一):双阱工艺(twin well process)
- CMOS制作步骤(二):浅槽隔离工艺STI(shadow trench isolation process)
- CMOS制作步骤(三):多晶硅栅结构工艺(poly gate structural process)
- CMOS制作步骤(四):轻掺杂漏注入工艺LDD(lightly doped drain implants process)
- CMOS制作步骤(五):侧墙的形成(side wall spacer formation)
- CMOS制作步骤(六):源/漏注入工艺(S/D implant process)
- CMOS制作步骤(七):接触(孔)形成工艺(contact formation)
- CMOS制作步骤(八):局部互连工艺LI(Local Interconnect process)
- CMOS制作步骤(九):Via-1, Plug-1及Metal-1互连的形成(Via-1 and Plug-1 formation)
- CMOS制作步骤(十):Via-2, Plug-2,Metal-2及Top Metal形成(Via-2,Plug-2,metal2 interconnect and top metal formation)