Abstract
一种具有高光电响应率的黑磷晶体、二维黑磷PN结及其制备方法与应用。所述具有高光电响应率的黑磷晶体为单晶,空间点群Cmca(no.64),晶胞参数为α=3.2~3.4Å,b=10.4~10.6Å,c=4.3~4.5Å,层间距 4~6Å,具有高光电响应率、半导体类型可调等优点,且其制备方法简单,条件温和,产率高、成本低、污染小。所述二维黑磷PN结包括二维黑磷薄膜,所述薄膜的第一区域被n型掺杂而形成n型半导体,第二区域保持为p型半导体,且第一、第二区域邻接,使n型半导体与p型半导体的结合面形成PN结。所述二维黑磷PN结具有单向导通性、光伏特效等性能,制备方法简单高效,可重复性好,与常规的半导体工艺兼容。所述的黑磷晶体和二维黑磷PN结在光电、电子领域有广泛应用前景。
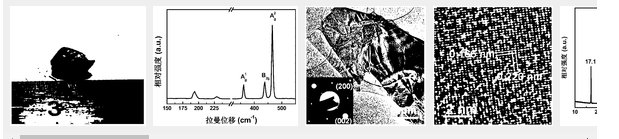
具有高光电响应率的黑磷晶体、二维黑磷PN结及其制备方法与应用技术领域
本申请涉及一种黑磷晶体材料,特别是涉及一种掺杂具有高光电响应率、半导体类型可调的黑磷晶体,以及一种二维黑磷PN结与其制备方法和应用。背景技术
自2004年石墨烯首次被发现以来,二维材料因其独特的性能受到了广泛的研究热潮。石墨烯具有优异力学、电学、光学、热学等性能,在透明导电电极、超级电容器、柔性器件、电池等诸多领域有巨大的应用潜能。但是石墨烯的缺点是没有带隙,所以不能应用于逻辑电路。过渡金属硫族化合物(TMDs)如MoS2、WS2等二维材料具有带隙,但其带隙范围较窄(1.2~1.8eV),在光探测器的应用方面就受到了限制。此外,TMDs的载流子迁移率低于现有的硅材料和石墨烯,这也限制了其在集成电路方面的性能表现。因此,开发一种能弥补石墨烯与TMDs之间的带隙空白,又具有优异载流子迁移率的新型二维半导体材料成为迫切需要。
黑磷是一种新型二维原子晶体材料,具有高载流子迁移率(~1000cm2/Vs)和开关比(>105),以及可调谐直接带隙(0.3—2eV)等优异性能,弥补了石墨烯的零带隙、过渡金属硫族化物(TMDs)载流子迁移率过低的性能缺陷,是继石墨烯之后又一让半导体技术和产业界感到振奋的二维材料,在光电探测器,逻辑电路,电池等领域有广泛应用前景,尤其在新型光电子器件,如高性能光探测器、光波导、锁模激光、调制器、偏振器等的开发应用方面显示了巨大的潜力。
目前,黑磷及其制备技术的研发多集中在本征黑磷上(例如CN104310326A,CN105133009A)。然而,本征黑磷为非对称的双极性P型半导体材料,既有电子电流又有空穴电流,但是电子的载流子浓度和迁移率都远低于空穴,即表现为p型导电、n型缺乏,且载流子浓度不可调控,这使得黑磷在某些领域的应用受到了限制。例如,其不适于制备互补型金属氧化物半导体逻辑电路(CMOS)等。又例如,本征黑磷与金属电极接触会有较高的肖特基势垒,抑制了光生载流子的传输,使得光电响应率偏低,不利于光电子器件的性能。
如何实现对黑磷的p型和n型进行有效调控,以简单、高效的构建性能优异的黑磷PN结构,进而拓展黑磷在诸如微纳器件,柔性器件等方面的应用,是本领域长期以来一 直渴望解决的难题,而本领域的众多研究人员也进行了大量研究。例如,有研究人员制备了黑磷-MoS2异质结,该方法需要剥离转移MoS2,还需要用到自对准技术,过程较复杂,而且成品率低。又例如,有研究人员利用双背栅结构制备了黑磷PN结,但是该方法也需要用到自对准技术,效率较低。
发明内容
本申请的主要目的在于提供一种具有高光电响应率的黑磷晶体、二维黑磷PN结及其制备方法与应用,以克服现有技术的不足。
为实现上述发明目的,本申请提供了如下技术方案:
本申请实施例提供了一种具有高光电响应率的黑磷晶体,其为单晶,空间点群Cmca(no.64),晶胞参数为

层间距

进一步的,所述黑磷晶体的XRD特征谱包括5个2θ峰:17.1°,26.6°,34.4°,40.2°,52.5°。
进一步的,所述黑磷晶体为半导体,半导体类型为p型或n型,带隙为0.1~2.5eV,开关比为103~106,载流子迁移率为10~30000cm2/Vs,优选为100~3000cm2/Vs。
进一步的,所述黑磷晶体内的掺杂元素包含磷、硼、碳、钠、镁、硫、钾、砷、锑、铋、硒、碲、铁、镍、氟、氯、溴、氢等元素中的任意一种或两种以上的组合,例如可以优选自磷、硼、碳、钠、镁、硫、钾或砷。
进一步的,所述黑磷晶体的光响应率大于1A/W。
本申请实施例还提供了一种具有高光电响应率的黑磷晶体的制备方法,其包括:
提供生长前驱物,所述生长前驱物包含质量比为(100~600):(10~100):(0.1~10)的红磷、矿化剂和掺杂元素;
将所述生长前驱物置于内腔为真空环境的密封反应容器内,并对所述反应容器依次进行加热、保温、降温,从而生长形成具有高光电响应率的黑磷晶体。
进一步的,所述掺杂元素包括硒、硫、碳、硼、砷、钠、镁、钾、锑、铋、硒、碲、铁、镍、氟、氯、溴、氢等元素中的任意一种或两种以上的组合。
本申请实施例还提供了所述的具有高光电响应率的黑磷晶体于光电领域的用途。
例如,本申请实施例还提供了一种光电探测器,其包含所述的具有高光电响应率的黑磷晶体,其光响应率大于1A/W。
进一步的,所述的光电探测器包含从所述黑磷晶体上剥离出的薄膜。
优选的,所述薄膜的厚度为1~20nm。
本申请实施例提供了一种二维黑磷PN结,其包括二维黑磷薄膜,所述黑磷薄膜的 第一区域被n型掺杂而形成n型半导体,而所述黑磷薄膜的第二区域保持为p型半导体,所述第一区域与第二区域邻接,使所述n型半导体与p型半导体结合形成PN结。
本申请实施例提供了一种二维黑磷PN结,其包括二维黑磷薄膜,至少所述黑磷薄膜表面的局部区域覆设有具有电荷转移掺杂特性的薄膜;并且至少在所述黑磷薄膜与所述具有电荷转移掺杂特性的薄膜的结合界面处,黑磷薄膜被掺杂而形成n型半导体;同时所述黑磷薄膜还包含作为p型半导体的黑磷;所述n型半导体与p型半导体配合形成PN结。
进一步的,所述黑磷薄膜至少可通过微机械剥离法或液相剥离法从黑磷晶体剥离获得。
本申请实施例还提供了一种二维黑磷PN结的制备方法,其包括:
提供二维黑磷薄膜;
对所述黑磷薄膜的局部区域进行n型掺杂形成n型半导体,同时使所述黑磷薄膜的其它局部区域保持为p型半导体,并使所述n型半导体与p型半导体配合形成PN结。
进一步的,所述制备方法可以包括:至少选用物理和/或化学沉积方式在所述黑磷薄膜表面的局部区域沉积具有电荷转移掺杂特性的薄膜,使所述黑磷薄膜的局部区域被n型掺杂形成n型半导体。
本申请实施例还提供了所述的二维黑磷PN结于制备电子器件或光电器件中的用途。
进一步的,所述电子器件或光电器件包括整流二极管、检波二极管、开关二极管、稳压二极管、雪崩二极管、半导体激光二极管、半导体发光二极管、光电探测器、太阳电池、双极型晶体管等,且不限于此。
与现有技术相比,本申请的优点包括:
(1)本申请提供的具有高光电响应率的黑磷晶体具有高光电响应率、半导体类型可调等优点;
(2)本申请提供的具有高光电响应率的黑磷晶体制备方法无需高温高压等苛刻条件,产率高、成本低、污染小,所制备黑磷晶体的结晶性好、掺杂均匀,半导体类型以及载流子浓度可调,并且在不需要后续修饰的情况下,可以直接从所述黑磷晶体剥离出二维薄膜材来料制备光电探测器,方法简单,成品率高,并且表现出极高的响应率,远高于现有的基于本征黑磷及其所构建异质结的光电探测器,尤其利于黑磷在光电探测等光电子器件领域的推广应用;
(3)本申请提供的二维黑磷PN结具有单向导通性、光伏特效等性能,适应于制备整理二极管、开关二极管、光伏电池等微纳器件,同时其制备方法简单高效,可重复性好,与常规的半导体工艺兼容,对实现黑磷在多领域的广泛应用具有积极意义。附图说明
为了更清楚地说明本申请实施例或现有技术中的技术方案,下面将对实施例或现有技术描述中所需要使用的附图作简单地介绍,显而易见地,下面描述中的附图仅仅是本申请中记载的一些实施例,对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这些附图获得其他的附图。
图1为本申请实施例1中黑磷晶体的照片。
图2为实施例1中硒掺杂的拉曼光谱仪测试曲线图。
图3为本申请实施例1中黑磷晶体的透射电镜照片及选区电子衍射图。
图4为本申请实施例1中黑磷晶体的晶格条纹图。
图5为本申请实施例1中黑磷晶体的XRD图。
图6a-图6b为本申请实施例1中黑磷晶体的磷和硒元素分布图。
图7为本申请实施例1中黑磷晶体的磷元素XPS图谱。
图8为本申请实施例1中黑磷晶体的硒元素XPS图谱。
图9是实施例5中的黑磷PN结的结构示意图。
图10是实施例5中的黑磷PN结的单向导通示意图。
图11是实施例6中的黑磷PN结的单向导通示意图。
图12是实施例8中的黑磷PN结光伏器件结构示意图。
图13是实施例8中黑磷PN结的光伏效应测试曲线图。
图14是实施例8中黑磷PN结的输出功率图。具体实施方式
本申请实施例的一个方面提供的一种具有高光电响应率的黑磷晶体为单晶,空间点群Cmca(no.64),晶胞参数为

层间距

本申请实施例的另一个方面提供的一种具有高光电响应率的黑磷晶体,其制备方法包括:
提供生长前驱物,所述生长前驱物包含质量比为(100~600):(10~100):(0.1~10)的红磷、矿化剂和掺杂元素;
将所述生长前驱物置于内腔为真空环境的密封反应容器内,并对所述反应容器进行加热,先在1~3小时内从室温升至600~850℃,并保温1~3小时,之后在1~24小时内降至450~550℃,并保温1~12小时,其后在1~4小时内降温至100~200℃,然后在1~3小时内降温至室温,最终形成具有高光电响应率的黑磷晶体,所述黑磷晶体为单晶,空间点群Cmca(no.64),晶胞参数为

层间距

进一步的,所述黑磷晶体的XRD特征谱包括5个2θ峰:17.1°,26.6°,34.4°,40.2°,52.5°。
进一步的,所述黑磷晶体为半导体,半导体类型为p型或n型可调,带隙在0.1~2.5eV范围内可调,开关比在103~106范围内可调,载流子迁移率在10~30000cm2/Vs范围内可调。
进一步的,所述黑磷晶体的载流子迁移率优选为100~3000cm2/Vs。
进一步的,所述黑磷晶体内的掺杂元素包含磷、硼、碳、钠、镁、硫、钾、砷、锑、铋、硒、碲、铁、镍、氟、氯、溴、氢元素中的任意一种或两种以上的组合,且不限于此。
进一步的,所述黑磷晶体的XPS图谱包括以下特征峰中的至少一个:磷129~132eV、硼189~194eV、碳283~286eV、钠1064~1080eV、镁1233~1237eV、硫160~172eV、钾290~300eV、砷40~50eV、锑32~36eV、铋156~160eV、硒53~58eV、碲567~590eV、铁718~723eV、镍850~855eV、氟682~690eV、氯194~202eV、溴66~70eV。
进一步的,所述黑磷晶体的光响应率大于1A/W。
本申请实施例的另一个方面提供的一种制备具有高光电响应率的黑磷晶体的方法包括:
提供生长前驱物,所述生长前驱物包含质量比为(100~600):(10~100):(0.1~10)的红磷、矿化剂和掺杂元素;
将所述生长前驱物置于内腔为真空环境的密封反应容器内,并对所述反应容器依次进行加热、保温、降温,从而生长形成具有高光电响应率的黑磷晶体。
在一些较为优选的实施方案中,所述的制备方法包括:对容置有所述生长前驱物的所述反应容器进行加热,先在1~3小时内从室温升至600~850℃,并保温1~3小时,之后在1~24小时内降至450~550℃,并保温1~12小时,其后在1~4小时内降温至100~200℃,然后在1~3小时内降温至室温,最终形成所述黑磷晶体。
进一步的,所述矿化剂包括锡、金、金锡合金、碘化锡、银、铜、镁锡铜合金中的任意一种或两种以上的组合,但不限于此。
进一步的,所述掺杂元素包括硒、硫、碳、硼、砷、钠、镁、钾、锑、铋、硒、碲、铁、镍、氟、氯、溴、氢元素中的任意一种或两种以上的组合。
在一较为具体的实施案例中,所述的制备方法包括:将所述前驱物装在石英管中,再将石英管真空封管,并水平放置在管式炉中加热,直至生长形成所述黑磷晶体。
本申请实施例还提供了由前述任一种方法制备的具有高光电响应率的黑磷晶体。
本申请实施例的又一个方面还提供了所述具有高光电响应率的黑磷晶体的用途,例如在光电领域的用途,例如在制备光电器件中的用途。
例如,本申请实施例提供了一种光电探测器,其包含所述的具有高光电响应率的黑磷晶体,其光响应率大于1A/W。
较为优选的,所述的光电探测器包含从所述黑磷晶体上剥离出的薄膜。
优选的,所述薄膜的厚度为1~20nm。
进一步的,所述薄膜分布在衬底上,且所述薄膜上设有电极。
进一步的,所述电极包括铬/金、钛/金、镍/金、铂/金等电极,但不限于此。
进一步的,所述衬底包括低阻硅衬底,但不限于此。
进一步的,所述光电探测器包括场效应晶体管。
本申请实施例提供了一种光电探测器的制作方法,其包括:从所述的黑磷晶体上剥离出厚度为1~20nm的黑磷薄膜,并转移至硅衬底上,然后通过电子束曝光或电子束蒸镀方法在所述黑磷薄膜上沉积电极。
本申请实施例的另一个方面提供的一种二维黑磷PN结包括二维黑磷薄膜,所述黑磷薄膜的第一区域被n型掺杂而形成n型半导体,而所述黑磷薄膜的第二区域保持为p型半导体,所述第一区域与第二区域邻接,使所述n型半导体与p型半导体结合形成PN结。
进一步的,在所述第一区域中本征黑磷被n型掺杂为n型黑磷,而第二区域中的黑磷未被掺杂,保持为呈p型的本征黑磷。
进一步的,n型黑磷与p型黑磷的交界面形成PN结。
本申请实施例的另一个方面提供的一种二维黑磷PN结包括二维黑磷薄膜,至少所述黑磷薄膜表面的局部区域覆设有具有电荷转移掺杂特性的薄膜;并且至少在所述黑磷薄膜与所述具有电荷转移掺杂特性的薄膜的结合界面处,黑磷薄膜被掺杂而形成n型半导体;同时所述黑磷薄膜还包含作为p型半导体的黑磷;所述n型半导体与p型半导体配合形成PN结。
在本说明书中,所述PN结的定义是业界已知的,其是构成双极型晶体管和场效应晶体管的核心,是现代电子技术的基础。进一步的,所述PN结是由一个N型掺杂区和一个P型掺杂区紧密接触所构成的半导体结构。根据PN结的材料、掺杂分布、几何结构和偏置条件的不同,利用其基本特性可以制造多种功能器件,如利用PN结单向导电性可以制作整流二极管、检波二极管和开关二极管、稳压二极管、雪崩二极管等。使半导体的光电效应与PN结相结合还可以制作多种光电器件,如利用前向偏置异质结的载 流子注入与复合可以制造半导体激光二极管与半导体发光二极管;利用光辐射对PN结反向电流的调制作用可以制成光电探测器;利用光生伏特效应可制成太阳电池。此外,利用两个PN结之间的相互作用可以产生放大,振荡等多种电子功能。
进一步的,前述黑磷薄膜的厚度可优选为0.5~100nm。
进一步的,前述黑磷薄膜可以是通过微机械剥离法或液相剥离法从黑磷晶体剥离获得,但不限于此。
进一步的,前述具有电荷转移掺杂特性的薄膜的厚度优选为5~2000nm。
进一步的,前述具有电荷转移掺杂特性的薄膜可通过物理和/或化学方式沉积于所述黑磷薄膜表面的局部区域。
本申请实施例的另一个方面提供的一种制备二维黑磷PN结的方法包括:
提供二维黑磷薄膜;
对所述黑磷薄膜的局部区域进行n型掺杂形成n型半导体,同时使所述黑磷薄膜的其它局部区域保持为p型半导体,并使所述n型半导体与p型半导体配合形成PN结。
在一些实施方案中,所述的制备方法包括:至少选用物理和/或化学沉积方式在所述黑磷薄膜表面的局部区域沉积具有电荷转移掺杂特性的薄膜,使所述黑磷薄膜的局部区域被n型掺杂形成n型半导体。
更进一步的讲,沉积于所述黑磷薄膜表面的、所述具有电荷转移掺杂特性的薄膜的组成物质自其与黑磷薄膜的结合界面处渗入所述黑磷薄膜,从而使所述黑磷薄膜的局部区域被n型掺杂形成n型半导体。
前述具有电荷转移掺杂特性的薄膜的材质包括2,3,5,6-四氟-7,7',8,8'-四氰二甲基对苯醌(C12F4N4)、1,5-萘二胺(C10H10N2)、9,10-二甲基蒽(C16H14)、9,10-二溴蒽(C14H8Br2)、1,3,6,8-芘四磺酸四钠盐(C16H6Na4O12S4)、SixNy(x:y=1:(0.5~2))、CsmCOn(m:n=1:(0.1~2))等有机、无机物质,但不限于此。
其中,所述物理和/或化学沉积方式包括旋涂、PECVD、ICPCVD、LPCVD、热蒸发、电子束热蒸发、磁控溅射、原子层沉积等方式,且不限于此。
进一步的,前述二维黑磷PN结具有单向导通的特性,使之适合于整流二极管、开关二极管的应用,但不限于此。
进一步的,前述二维黑磷PN结具有光伏特性,其表征参数包括:短路电流为1~200纳安,开路电压为1~500毫伏,最大输出功率为1~100纳瓦,使之适合于太阳能电池的应用。
进一步的,前述二维黑磷PN结具有光电响应,使之适合于光探测器的应用。
本申请实施例还提供了由所述方法制备的二维黑磷PN结。
本申请实施例还提供了所述的二维黑磷PN结于制备电子器件或光电器件中的用途。
本申请实施例还提供了电子器件或光电器件,其包含:所述的二维黑磷PN结;以及,与所述黑磷PN结连接的电极。
进一步的,所述电子器件或光电器件包括场效应晶体管、整流二极管、检波二极管、开关二极管、稳压二极管、雪崩二极管、半导体激光二极管、半导体发光二极管、光电探测器、太阳电池或双极型晶体管等,但不限于此。
为了进一步理解本申请,下面将结合若干实施例及附图对本申请进行详细说明。但是,应当理解,本领域技术人员可以借鉴本说明书的内容,适当改进工艺参数实现。特别需要指出的是,所有类似的替换和改动对本领域技术人员来说是显而易见的,它们都被视为包括在本申请。本申请的应用已经通过较佳实施例进行了描述,相关人员明显能在不脱离本申请内容、精神和范围内对本文所述的应用进行改动或适当变更与组合,来实现和应用本申请技术。
实施例1:本实施例涉及一种硒掺杂黑磷晶体的制备方法,包括:
将前驱物红磷、锡、铜、硒按(550~600):(10~20):(20~40):(0.1~0.5)的质量比装入石英管中,并将石英管真空封管。随后将石英管水平的放置在管式炉中加热生长,其具体过程包括:3小时内从室温升至850℃,并保温1小时,之后在24小时内降至450℃,并保温6小时,其后在3小时内降温至100℃,然后在1小时内降温至室温,最后得到黑磷晶体。其中一种典型黑磷晶体产品的照片可参阅图1,其拉曼光谱可参阅图2,因此可验证该晶体是硒掺杂黑磷。再请参阅图3是该硒掺杂黑磷晶体的透射电镜结果,插图是选区电子衍射图,表明该硒掺杂黑磷晶体具有高晶体性。另请参阅图4是该硒掺杂黑磷晶体的晶格条纹图,其原子间距在x和y方向的间距分别是0.166和0.220纳米。其XRD特征谱包括5个2θ峰:17.1°、26.6°、34.4°、40.2°、52.5°(参阅图5)。硒元素在该硒掺杂黑磷晶体中分布较为均匀(参阅图6a-图6b),另外,XPS图谱证明了该硒掺杂黑磷晶体中包含磷元素和硒元素(参阅图7和图8)。而对本实施例所获的其它黑磷晶体产品进行表征,亦可得到相似测试结果。
进一步的,在本实施例的该典型硒掺杂黑磷晶体的基础上,还可制备二维黑磷半导体光电探测器,具体方法包括:
采用微机械剥离的方法将黑磷薄膜(厚约1~20纳米)转移至低阻硅衬底上,然后用电子束曝光、电子束蒸镀的方法沉积了铬/金电极(厚约10/90纳米),制备了场效应晶体管。电学测试表明该器件性能优异,电极与黑磷沟道的接触良好,硒掺杂黑磷为P型半导体,开关比均在103以上且可达106,空穴迁移率平均约561cm2/Vs(最高可达约3000cm2/Vs),电子迁移率平均约51cm2/Vs。同时,还测试了硒掺杂黑磷光电探测器的 光电性能,其光电响应率平均约15.33*103mA/W,远高于基于本征黑磷及异质结的光电探测器。
而依据前述方法,对利用本实施例所获的其它黑磷晶体产品构建的光电探测器进行性能测试,亦可得到相似测试结果。
实施例2:本实施例涉及一种硫掺杂黑磷晶体的制备方法,包括:
将前驱物红磷、锡、碘化锡、硫按(100~150):(60~80):(30~40):(0.1~2)的质量比装入石英管中,并将石英管真空封管。随后将石英管水平的放置在管式炉中加热生长,具体过程包括:在1小时内从室温升至600℃,并保温3小时,之后在12小时内降至500℃,并保温12小时,其后在1小时内降温至150℃,然后在2小时内降温至室温,最终形成所述黑磷晶体。最后得到黑磷晶体,其中的硫掺杂量平均约0.2wt%。
在前述硫掺杂黑磷晶体的基础上,可以制备二维黑磷半导体光电探测器。具体方法如下:用微机械剥离的方法将黑磷薄膜(厚约10纳米)转移至低阻硅衬底上,然后用电子束曝光、电子束蒸镀的方法沉积了铬/金电极(10/90纳米),制备了场效应晶体管。电学测试表明器件性能优异,电极与黑磷沟道的接触良好,硫掺杂黑磷为n型半导体,开关比均在103以上且可达106,空穴迁移率平均约283cm2/Vs,电子迁移率平均约673cm2/Vs。同时,还测试了硫掺杂黑磷光电探测器的光电性能,其光电响应率平均约1.65*103mA/W,远高于基于纯黑磷及异质结的光电探测器。
实施例3:本实施例涉及一种镁掺杂黑磷晶体的制备方法,包括:
将前驱物红磷、金锡合金、锡、镁按(550~600):(50~70):(25~35):(7~10)的质量比装入石英管中,并将石英管真空封管。随后将石英管水平的放置在管式炉中加热生长,具体过程包括:在2小时内从室温升至750℃,并保温2小时,之后在24小时内降至550℃,并保温1小时,其后在4小时内降温至200℃,然后在3小时内降温至室温,最后得到镁掺杂量平均约0.6wt%的黑磷晶体。
在前述镁掺杂黑磷晶体的基础上,可以制备二维黑磷半导体光电探测器。具体方法如下:用微机械剥离的方法将黑磷薄膜(厚约14纳米)转移至低阻硅衬底上,然后用电子束曝光、电子束蒸镀的方法沉积了铬/金电极(10/90纳米),制备了场效应晶体管。电学测试表明器件性能优异,电极与黑磷沟道的接触良好,镁掺杂黑磷为P型半导体,开关比均在103以上且可达106,空穴迁移率平均约2896cm2/Vs,电子迁移率平均约26cm2/Vs。同时,还测试了镁掺杂黑磷光电探测器的光电性能,其光电响应率平均约2.16*103mA/W,远高于本征黑磷及异质结光电探测器。
实施例4:本实施例涉及一种砷掺杂黑磷晶体的制备方法,包括:
将前驱物红磷、锡、金、砷按(300~350):(30~40):(15~20):(3~5)的质量比装入石英管中,并将石英管真空封管。随后将石英管水平的放置在管式炉中加热生长,具体过程包括:在2小时内从室温升至700℃,并保温3小时,之后在10小时内降至500℃,并保温3小时,其后在4小时内降温至100℃,然后在3小时内降温至室温,最后得到砷掺杂量平均约1wt%的黑磷晶体。
在前述砷掺杂黑磷晶体的基础上,可以制备二维黑磷半导体光电探测器。具体方法如下:用微机械剥离的方法将黑磷薄膜(16纳米)转移至低阻硅衬底上,然后用电子束曝光、电子束蒸镀的方法沉积了铬/金电极(10/90纳米),制备了场效应晶体管。电学测试表明器件性能优异,电极与黑磷沟道的接触良好,砷掺杂黑磷为P型半导体,开关比均在103以上且可达106,空穴迁移率平均约526cm2/Vs,电子迁移率平均约56cm2/Vs。同时,还测试了砷掺杂黑磷光电探测器的光电性能,其光电响应率平均约4.96*103mA/W,远高于基于本征黑磷及异质结的光电探测器。
实施例5:用微机械剥离法或液相剥离法从黑磷晶体剥离获得5~20纳米厚的黑磷薄膜,将所述黑磷薄膜转移至衬底上,所述衬底包括但不限于硅片、石英、氧化硅、碳化硅、氧化铝、PET等。进一步的,在所述黑磷薄膜局部的表面沉积一层SixNy薄膜,沉积方式包括PECVD、ICPCVD、LPCVD或热蒸发等,沉积方式中采用的硅源气体包括SiN4、SiF4、SiCl3H、SiCl4、SiH2Cl2中的任意一种或两种以上的组合,但不限于此。沉积方式中采用的氮源气体包括N2O、N2、NH3中的任意一种或两种以上的组合,但不限于此。进一步的,所述物理和/或化学沉积方式中采用的硅源气体与氮源气体的体积比优选为1:(0.1~10)。本实施例的二维黑磷PN结的如图9所示,包括衬底1,n型黑磷2,p型黑磷3和SixNy薄膜4。
进一步的,在前述制备方法中,可以通过改变SiNX薄膜的厚度、SiNX薄膜中Si和N的比例,就能实现对黑磷PN结性能的调控。
进一步的,前述SixNy薄膜的厚度优选为10~100nm。
进一步的,前述SixNy薄膜中x:y=1:(0.5~2)。
本实施例获得的二维黑磷PN结样品均具有明显的单向导通性,例如其中一典型黑磷PN结样品的测试结果可参阅图10,这些黑磷PN结适用于制备开关二极管。
实施例6:用微机械剥离法或液相剥离法从黑磷晶体剥离获得40~60纳米厚的黑磷薄膜,将薄膜转移至硅衬底上,然后用旋涂的方法在该黑磷表面局部区域沉积一层1,5-萘二胺薄膜,膜厚1000~2000纳米。测试电学性能发现,本实施例获得的二维黑磷PN结样品也均具有明显的单向导通性,例如其中一典型黑磷PN结样品的测试结果可参阅图11。这些黑磷PN结适用于制备整流二级管。
实施例7:用微机械剥离法从黑磷晶体剥离获得10~30纳米厚的黑磷薄膜,并转移至硅衬底上,进一步的,黑磷表面的局部区域镀上10~25纳米厚的CsmCOn薄膜,形成二维黑磷PN结构。镀膜方法包括PECVD、ICPCVD、LPCVD、热蒸发等,沉积方式中采用的铯源包括氢氧化铯、硝酸铯中的任意一种或两种以上的组合,碳酸源包括二氧化碳、草酸的任意一种或两种以上的组合。CsmCOn薄膜厚度为10~25纳米其中m:n=1:(0.1~2)。本实施例获得的二维黑磷PN结样品也均具有明显的单向导通性,这些黑磷PN结适用于制备稳压二级管。
实施例8:经光电性能测试发现,本实施例获得的二维黑磷PN结样品均具有明显的光伏特性。例如,一典型黑磷PN结样品形成的器件,器件结构示意图如图12,包括衬底1,衬底材料包括硅片、石英、氧化硅、碳化硅、氧化铝、PET等,n型黑磷2,p型黑磷3,于本说明书中述及的任意一种具有电荷转移特性的薄膜4,源极电极5,漏极电极6,电极材料包括金、铬、钛、镍、铂等。用波长403纳米的激光照射该器件,测到了光伏效应(如图13),其短路电流为50~150纳安,开路电压为200~300毫伏,其最大输出功率为50~80纳瓦(如图14)。因此,这些黑磷PN结表现出光伏特性,适用于制备光伏器件。
需要说明的是,本申请的附图均采用非常简化的形式且均使用非精准的比率,仅用于方便、明晰地辅助说明本申请的实施例。
最后还需要说明的是,术语“包括”、“包含”或者其任何其他变体意在涵盖非排他性的包含,从而使得包括一系列要素的过程、方法、物品或者设备不仅包括那些要素,而且还包括没有明确列出的其他要素,或者是还包括为这种过程、方法、物品或者设备所固有的要素。